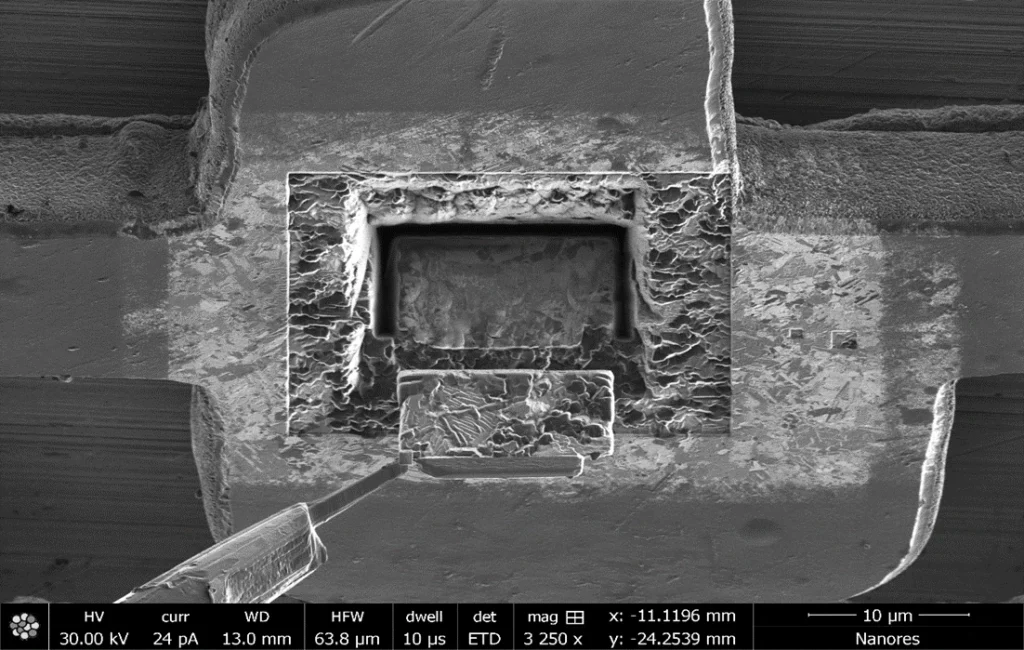
TEM lamella preparation
One of the main use of the dual beam SEM/FIB (Scanning Electron Microscope) / (Focused Ion Beam) systems is the sample preparation for TEM (Transmission Electron Microscopy). In order for the TEM measurement to be possible, a sample preparation should be conducted in such a way that its thickness is below 100nm. This critical thickness allows the electron beam to be transmitted through the sample and this enables imaging of fine micro structure of the specimen.
The lift-out method as ion beam technique with utility of dual beam systems SEM/FIB is one of many among TEM lamella preparation processes. Although lift-out method is in general more expensive it gives better TEM results and the technique itself is direct, flexible and it is 100% controlled by the SEM/FIB operator.
Deliverables
What is the type of material?
What is the area of interest?
What is the goal of the measurements?
– TEM lamella preparation
– TEM measurements
Contact Listings Owner Form
- Learn about who has visited this offer
- Get funding opportunities matching this technology
- Get detailed access statistics as listing owner